ウエハ上の汚染粒子検査装置
本装置は、ウエハ基板、液晶ディスプレイ用透明ガラス、SAWフィルタ用の半透明基板などの被検査物表面上の異物・表面を高精度に高速検査する装置です。従来技術では検査が困難で時間のかかった基板や、裏面の荒れた基板上の汚染粒子・異物や微細領域の表面の凹凸、スクラッチ等の欠陥を、本装置では、大視野で瞬時にそれらを識別し、その位置を特定することを可能にしました。
<従来技術>
表面が鏡面のSiウエハの表面に付着した汚染粒子の検査をする場合、既存の技術では、下記の様に、レーザ光を入射して、付着粒子 が散乱する光をCCDセンサにて捕捉・認識し、カウントし、ある一定以上のクリーン度を示すウエハを出荷しています。しかしながら 、X・Y軸に沿ってスキャンをしなければならず、スループットが上がらない問題点があります。また、携帯電話に使っているSAWフィルターなどの半透明結晶の検査の場合は、荒れた裏面での散乱光の影響で十分なS/Nの信号を得る ことができず、検出粒子径に限界がありました。

<本装置の特徴>
レーザー照射光を基板側方から基板面に対して平行に照射し、照射光を基板面に対して垂直方向に移動させ、基板面上に付着する粒子や、基板面上の凹凸、スクラッチ等を計測検査する装置です。基板面より広い範囲のシート状光を使用し、基板の外形と位置を瞬時に記録し,ついで基板表面に付着した汚染微粒子からの散乱光を記録し、更に散乱光の強度から粒子径を求めることで、基板上の全汚染微粒子の位置とそれぞれの粒径を一括して測定できます。
<実験装置概要>
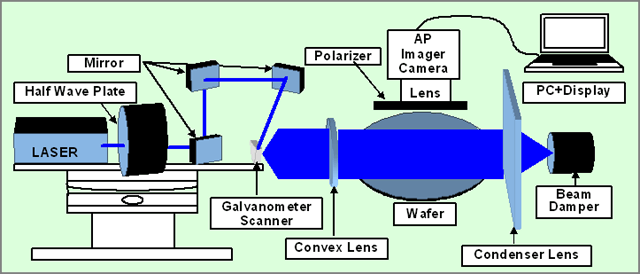
<測定結果の例(粒子存在位置,粒径分布図,粒子位置座標,粒径のサイズごとのカラー表示)>


